Apps & Mobile Entwicklung
High Bandwidth Flash: Arbeiten am HBF-Standard starten im März

Gemeinsam wollen SK Hynix und Sandisk den vor einem Jahr vorgestellten High Bandwidth Flash (HBF) zu einem neuen Speicherstandard erheben. Jetzt wurde der nächste Schritt verkündet. Die Arbeiten am HBF-Standard sollen im Rahmen des Open Compute Project (OCP) im März begonnen werden.
„Indem wir HBF gemeinsam mit Sandisk zu einem Industriestandard machen, legen wir den Grundstein für das gemeinsame Wachstum des gesamten KI-Ökosystems. Ein eigener Arbeitsbereich im Rahmen von OCP wird zusammen mit Sandisk eingerichtet, um mit der Standardisierungsarbeit zu beginnen“, heißt es in der Pressemitteilung von SK Hynix.
Neue technische Informationen oder Spezifikationen gibt es an dieser Stelle allerdings nicht. Ebenso bleibt unklar, wann die Serienfertigung beginnt. Zumindest wird eingegrenzt, dass der Bedarf an Speicherlösungen wie HBF ab dem Jahr 2030 zunehmen soll. Somit dürften die Partner in etwa für diesen Zeitraum mit dem Marktstart planen.
Dass die Branche überhaupt einen Speicher wie HBF benötigen soll, wird mit den wachsenden Ansprüchen im Bereich der Künstlichen Intelligenz begründet.
Allmählich verlagere sich der Fokus vom Training der KI-Modelle hin zur Inferenz, also der Anwendung des „Erlernten“ in Echtzeit. Dafür sei nun insbesondere schneller, aber auch energieeffizienter Speicher nötig. Bisher fehle es an einer Lösung zwischen dem sehr schnellen High Bandwidth Memory (HBM) und dem Massenspeicher SSD. Genau diese Lücke soll HBF füllen, und zwar als Ergänzung der bestehenden Speicherlösungen und nicht als Ersatz, wird betont: „Während HBM die hohe Bandbreite verarbeitet, dient die HBF-Technologie als unterstützende Schicht in der Architektur“.
Das ist bisher zur Technik bekannt
Bei der ersten Ankündigung von HBF im Februar 2025 hatte Sandisk eine 8- bis 16-fache Speicherkapazität gegenüber HBM in Aussicht gestellt. Der Aufbau ist dabei dem von HBM sehr ähnlich, nur dass eben statt DRAM-Dies mehrere NAND-Flash-Dies übereinandergestapelt und mittels TSV vertikal verbunden werden. Bis zu 16 Schichten (16H Stacking) sind dabei angedacht.
- High Bandwidth Flash: SanDisk plant Riesenspeicher für KI-Beschleuniger
Im vergangenen Sommer wurde bekannt, dass Raja Koduri, der seinerzeit Pionierarbeit bei AMD für HBM geleistet hatte, auch beim High Bandwidth Flash mit Rat zur Seite stehen wird. Neben Koduri wird David Patterson, ein renommierter Professor der Computer Science und Google-Ingenieur, zum technischen Beirat zählen und diesen anführen.
Apps & Mobile Entwicklung
CoWoS-Nachfolger kommt später: TSMCs Pilotlinie für CoPoS wird erst 2028 fertig – für Produkte in 2030+

TSMC bestätigte erstmals, eine Pilotlinie für CoPoS als neuen Packaging-Standard zu bauen. Aber bis zur Markteinführung wird es lange dauern, womit das Unternehmen auch Gerüchten begegnet, die zuletzt eine schnelle Adaption durch Nvidia vermutet hatten. Zwischen Wunsch und Realität liegen demnach wohl doch gewaltige Aufgaben.
CoWoS steht für „Chips on Wafer on Substrat“. Es ist die aktuelle Packaging-Technologie von TSMC, mit denen Nvidia, AMD und viele weitere Firmen, beispielsweise GPU-Dies zusammen mit HBM auf einem Package vereinen und so erst den nutzbaren KI-Beschleuniger hervorbringen. CoWoS hat dabei schon einige Entwicklungsstufen durchgemacht und ist stetig gewachsen, sprich der Interposer ist größer geworden, um noch mehr Chips aufzunehmen
Doch der Ruf nach noch mehr Leistung braucht nun neue Ansätze. Diese suchen die Unternehmen gemeinsam auch beim Packaging. TSMC brachte unter anderem SoW-X ins Spiel, ein System auf einem Wafer. Für gewisse Zwecke funktioniert das auch, an einem klassischen rechteckigen oder quadratischen Substrat scheint in Zukunft aber dennoch kein Vorbeikommen zu sein. Die nächste Stufe heißt deshalb CoPoS.

CoPoS steht für „Chips on Panel on Substrat“. Panel bezieht sich in dem Fall auf die Fertigung der passenden und viel größeren Substrate, die nun nicht mehr von einem runden Wafer bezogen werden, sondern einem rechteckigen Panel. Auch in anderen Bereichen soll das Panel-level Packaging (PLP) gegenüber dem Wafer-level Packaging (WLP) in Zukunft an manchen Stellen Vorrang erhalten, es verspricht nämlich eine höhere Wirtschaftlichkeit – unter anderem beim zukünftigen Glas-Substrat. Dort war bereits von Größen bis zu 600 × 600 mm die Rede, CoPoS geht also in eine ähnliche Richtung.
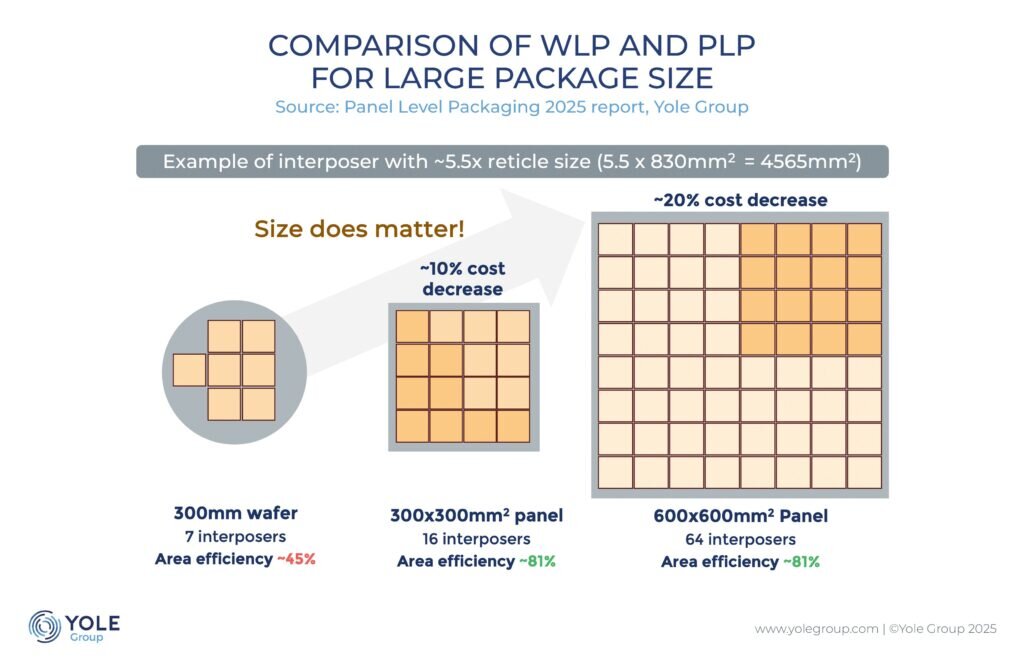
TSMC bestätigt CoPoS-Entwicklung mit langen Zeiten
Im Rahmen des Quartalsberichts bestätigte TSMC erstmals ganz öffentlich eine Produktionslinie für CoPoS zu bauen. Damit fängt das Unternehmen aber erst im zweiten Halbjahr dieses Jahres an, im kommenden Jahr soll die Einrichtung dann ausgerüstet werden und die Erprobung beginnen. Das Ziel ist es, diese eventuell ab 2028 dann in den Status „Bereit zur Serienproduktion“ überführen zu können. Dafür würde aber eine echte Packaging-Fabrik ausgerüstet werden müssen, ein Start in Serie wäre so frühestens ab Ende 2029 absehbar, mit Produkten für das Jahr 2030. Und all dies würde vor allem gegenüber CoWoS auf so vergleichbar winzigem Niveau passieren, dass es zu Beginn ein echtes Nischenprodukt ist und auch noch längere Zeit bleibt.
Zuvor muss dabei aber auch ersten Problemen begegnet werden, denn die Umsetzung für eine Großserie scheint demnach nicht so leicht zu sein, berichtet DigiTimes aus Asien dazu. Die größeren Chips/Packages haben demnach Probleme mit „uniformity“ und „warpage“ – exakt dies wurde unter anderem aber auch schon als Grund bei Nvidias riesigem Rubin-Ultra-Die genannt, sodass es hier eventuell ein neues Packaging braucht.
An CoWoS ist deshalb wohl im nächsten Jahrzehnt kaum ein vorbeikommen – für die nächsten zwei Jahre ist es aber schon wieder nahezu ausgebucht, also so, wie die letzten fünf Jahre bereits. Die nächste Stufe umfasst weitere Verbesserungen, ein mittels SoIC gestapelte Chip wie beispielsweise ein Ryzen X3D kann nun auch noch mittels CoWoS auf einem Interposer platziert werden. Dies eröffnet neue Möglichkeiten für kommende Generationen an Chips. In der kommenden Woche beim TSMC Technology Symposium 2026 dürfte das Unternehmen auch diesen Punkt als Thema eröffnen.
Apps & Mobile Entwicklung
AMD-Aktie auf Rekordniveau: Angebliche Instinct-MI450-Nutzung bei Anthropic beflügelt

Anthropic sucht per Stellenausschreibung Personal, dass sich neben Nvidias CUDA auch mit ROCm auskennt, also dem AMD-Gegenstück von CUDA. Dieses eine Wort und weitere, zum Teil darauf basierende Gerüchte haben gereicht, dass AMDs Aktie an der Börse reagiert und zum Rekord angesetzt hat.
In der schnelllebigen AI-Zeit kann schon ein Gerücht für deutliche Aktienbewegungen sorgen. Zuletzt schaffte das die Meldung, dass Nvidia einen PC-Hersteller übernehmen könnte. Nun war AMD an der Reihe, diesmal gepaart mit der Meldung, dass Instinct MI450 bei Anthropic unterkommen könnten. Da dieses Gerücht nahezu parallel zur Stellenausschreibung aufkam, ging es für die Aktie entsprechend aufwärts, die erstmals bei über 278 US-Dollar lag.
Rückhalt bekommt der gute Ausblick bei AMD aber auch durch die bereits in dieser Woche veröffentlichten Quartalsberichte von ASML und den sehr guten Zahlen von TSMC. Denn beide sehen kein Ende des KI-Booms, im Gegenteil. Die Aussichten der Unternehmen, die für die Fertigung der Chips von AMD & Co nötig sind, sehen sehr gut aus, was darauf hindeutet, dass die Kundschaft eine entsprechende Nachfrage geäußert hat.
Bei AMD beginnt in diesem Jahr das Zeitalter der Rackscale-Architektur. Helios ist die erste Verschmelzung von Zen-6-Venice-Server-Prozessoren mit Instinct-MI450-AI-Beschleunigern in einem großen Rack. In schneller Folge sollen in den kommenden Jahren weitere Produkte folgen. MI500 mit noch mehr HBM4e und einem darauf angepassten Prozessor Verano – hier erstmals mit von AMD kürzlich bestätigtem SOCAMM2-Speicher – soll neben der Leistung auch die Effizienz im Fokus haben.

Bei Anthropic dürfte auch das Helios-Rack im Gespräch sein, da es explizit auf Hyperscaler und AI ausgelegt ist. Pro Rack kommen 72 MI455X zum Einsatz, die für 2,9 ExaFLOPS an KI-Leistung sorgen sollen. Die Epyc-Prozessoren der nächsten Generation kommen zusammen auf 4.600 Kerne und die 31 TB an HBM4 sollen vereint für 43 TB/s Durchsatz sorgen. Die offizielle Vorstellung dieser Systeme und aller Bauteile wird im Rahmen des Events AMD Advancing AI 2026 ab 22. Juli erwartet.
Apps & Mobile Entwicklung
DeepL: Echtzeit-Sprachübersetzung mit Voice-to-Voice nun Realität

Das KI-Übersetzungstool DeepL hat mit DeepL Voice-to-Voice eine neue Produktreihe vorgestellt, die eine Sprachübersetzung in Echtzeit per mündlicher Kommunikation ermöglicht. Der Einsatz ist insbesondere in virtuellen Meetings vorgesehen, sodass Teams weltweit mühelos über Sprachbarrieren hinweg zusammenarbeiten können sollen.
Kommunikation ohne menschlichen Übersetzer
Gespräche in unterschiedlichen Sprachen sollen damit künftig vollständig ohne Dolmetscher auskommen. DeepL Voice-to-Voice ermöglicht es, ganz natürlich in der eigenen Sprache zu sprechen, während das Gesagte beim Empfänger präzise übersetzt wird. Laut CEO Jarek Kutylowski kombiniert DeepL hierfür die bekannten eigenen Sprachmodelle mit der ebenfalls eigenen, bewährten KI-Übersetzungstechnologie, um insbesondere Unternehmen eine barrierefreie Kommunikation zu ermöglichen.
Die neue Technologie fußt dabei auf fünf zentralen Eckpfeilern:
- Voice for Meetings soll eine Echtzeit-Übersetzung auf Plattformen wie Microsoft Teams und Zoom ermöglichen, wobei Teilnehmer in ihrer Muttersprache sprechen, während die Empfänger die Inhalte in ihrer jeweils gewählten Sprache hören. Das Early-Access-Programm soll im Juni dieses Jahres starten, eine Registrierung ist ab sofort möglich.
- Voice for Conversations richtet sich primär an den mobilen Einsatz, geht jedoch darüber hinaus und soll eine plattformübergreifende Übersetzung bieten, insbesondere für Szenarien, in denen die Installation von Apps nicht praktikabel oder zulässig ist.
- Mit Gruppenkonversationen will DeepL den mehrsprachigen Austausch in Trainings, Coachings und Workshops erleichtern, indem Teilnehmer per QR-Code direkt dem Gespräch beitreten und dank Multi-Device-Zugang gleichzeitig Echtzeit-Übersetzungen empfangen können. Diese Funktion soll ab dem 30. April verfügbar sein.
- Darüber hinaus ermöglicht die Voice-to-Voice-API Unternehmen, die Sprachübersetzung direkt in interne Anwendungen sowie kundenorientierte Tools zu integrieren; hier hat das Early-Access-Programm bereits begonnen, eine Registrierung ist weiterhin möglich.
- Ergänzend sollen neue Optimierungsfunktionen sicherstellen, dass spezifische Terminologie wie Branchenbegriffe, Produktnamen oder Eigennamen auch bei schneller oder technischer Sprache präzise erkannt und entsprechend verarbeitet, also bei Bedarf nicht übersetzt werden. Bestehende DeepL-Glossare werden dafür in DeepL Voice integriert, um eine einheitliche Terminologie über alle Gespräche hinweg zu gewährleisten. Diese Funktion soll ab dem 7. Mai verfügbar sein.
Großes Sprachpaket bereits zum Start vorhanden
DeepL richtet die neue Technologie auch auf eine einfache Zugänglichkeit für kleinere Teams aus. Das Self-Service-Modell erlaubt es Unternehmen, die Lösung im Rahmen eines kostenlosen Testzeitraums unmittelbar zu implementieren und zu erproben, bevor der Einsatz ausgeweitet wird. Zum Start von Voice-to-Voice wird bereits eine breite Auswahl an Sprachen unterstützt, darunter alle 24 offiziellen EU-Sprachen sowie Arabisch, Bengalisch, Hebräisch, Norwegisch, Tagalog, Thailändisch und Vietnamesisch. Insgesamt soll DeepL Voice zum Start mehr als 40 Sprachen abdecken.
DeepL will komplette Infrastruktur für Übersetzungen erschaffen
Parallel zum Launch von Voice-to-Voice entwickelt DeepL sein Kernprodukt, das nach eigenen Angaben weltweit von über 200.000 Teams sowie Millionen von Einzelnutzern genutzt wird, zur nächsten Generation der Übersetzungsplattform weiter. Ziel ist der Aufbau einer End-to-End-Übersetzungsinfrastruktur für moderne Unternehmen. Damit sollen Ineffizienzen klassischer Übersetzungsmanagements beseitigt werden, die nach Ansicht des Unternehmens häufig auf langsamen, starren und manuellen Prozessen beruhen und entsprechend hohe Kosten verursachen. „Globale Unternehmen haben heute kein reines Übersetzungsproblem mehr; sie haben ein strukturelles Problem im Betriebsablauf. Heutige Sprachlösungen lassen sich oft nicht schnell genug skalieren und bremsen so das Wachstum“, erklärt Jarek Kutylowski das Vorhaben.
-
Künstliche Intelligenzvor 2 Monaten
Top 10: Die beste kabellose Überwachungskamera im Test – Akku, WLAN, LTE & Solar
-

 Social Mediavor 2 Monaten
Social Mediavor 2 MonatenCommunity Management und Zielgruppen-Analyse: Die besten Insights aus Blog und Podcast
-

 Social Mediavor 2 Monaten
Social Mediavor 2 MonatenCommunity Management zwischen Reichweite und Verantwortung
-

 UX/UI & Webdesignvor 3 Monaten
UX/UI & Webdesignvor 3 MonatenEindrucksvolle neue Identity für White Ribbon › PAGE online
-

 Entwicklung & Codevor 1 Monat
Entwicklung & Codevor 1 MonatCommunity-Protest erfolgreich: Galera bleibt Open Source in MariaDB
-

 Künstliche Intelligenzvor 3 Monaten
Künstliche Intelligenzvor 3 MonatenInterview: Massiver Anstieg der AU‑Fälle nicht durch die Telefon‑AU erklärbar
-

 Künstliche Intelligenzvor 2 Monaten
Künstliche Intelligenzvor 2 MonatenSmartphone‑Teleaufsätze im Praxistest: Was die Technik kann – und was nicht
-

 Entwicklung & Codevor 3 Monaten
Entwicklung & Codevor 3 MonatenKommentar: Entwickler, wacht auf – oder verliert euren Job



















